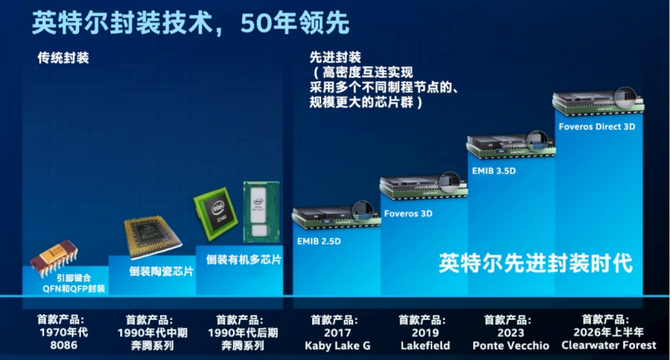 在AI开发浪潮中,一项技术从“幕后”转变为“舞台前”,即半导体的高级包装。这项技术可以在单个设备上使用各种功能,过程,大小和制造商的芯片组合,并以灵活,节能和成本经济的方式创建芯片上的系统(SOC)。因此,更多的AI芯片制造商更喜欢这项技术。自1970年代以来,英特尔一直在不断变化,加深了其包装技术,并积累了超过50年的丰富经验。在AI期间,英特尔与生态系统合作伙伴和基板供应商合作,汇总了制定标准并领导整个行业的高级包装技术的应用。 Intel OEM不仅可以为客户提供传统的包装,互连,基材和其他技术的概念(STCO)的概念的遵从性,而且还涵盖了系统体系结构级别S和设计服务以及全面的支持,例如热管理和功耗。包装和测试(Intel Foundry ASAT)技术的组合,包括FCBGA 2D,FCBGA 2D+,EMIB 2.5D,EMIB 3.5D,FOVEROS 2.5D 3D和FOVEROS DIRECT 3D。 FCBGA 2D是一种传统的有机FCBGA(翻转芯片球网格阵列),适用于具有敏感和低I/O数量的产品,可以降低相干关系并降低成本,特别适用于网络和转移设备等产品。 ・EMIB(嵌入式多芯片互连桥)2.5D技术通过基板内部的微硅桥连接芯片,适用于具有高芯片间密度的连接,并在AI和高表演计算场(HPC)中表现出色。 ・EMIB 3.5D在此基础上介绍了3D基础技术。芯片可以在主动或被动基材上垂直垂直垂直,然后通过EMIB技术连接,CH提高了灵活性,并允许您根据IP的特征垂直或水平搜索,同时避免使用大型介体。 ・Foveros 2.5D和3D技术采用了基于焊料的焊料,而不是基板连接,适用于高速I/或较小芯片组的设计。 ・Foveros Direct 3D技术通过直接铜和铜粘结提供了出色的性能。值得注意的是,这些技术并非既有独家店,而是可以在包装中同时采用的,从而为复杂芯片设计提供了极大的灵活性。在商业层面,它反映了农场智力的包装部分。 EMIB:正确的AI芯片包装。与其他晶圆级2.5D行业技术相比,EMIB 2.5D技术具有许多优势,例如硅插层和层崩溃(RDL)。首先,成本是有效的。 EMI使用的硅桥B技术的尺寸很小。与传统的大型插头相比,功夫可以在制造过程中更好地使用晶圆区域,减少空间和资源浪费,并且总成本较低。其次,收益率提高了。 EMIB技术消除了晶圆级组件,从而降低了由模具和颠簸等复杂过程引起的损失产量的风险,从而提高了整体劳动力过程的产量。第三,卓越劳动力。与晶圆技术相比,EMIB技术的制造步骤较少,复杂性较低,因此它具有较短的生产周期,可以在重要的时候节省客户。如果快速改变市场动态,这次的优势将帮助客户更快地获得产品的-DEREF数据,并加速产品的发布。第四,反对派的大小。晶圆水平技术需要在基板上方添加插槽层,而EMIB则将硅桥放在子板上Strate,它极大地改善了底物区域的使用。同时,底物的大小对应于集成电路面板的格式,并且使用EMIB的使用提供了单个软件包中更多芯片,以容纳更多的工作负载。第五,供应链和生产能力。英特尔具有成熟的供应链和足够的生产能力,可确保EMIB可以满足客户对高级包装解决方案的需求。未来,英特尔产生的超额包装为120×120mm,并计划在SUS Marketit上推出玻璃基材已有几年了。与当前使用的有机基材相比,玻璃基板具有独特的特性,例如超低降低平面,更好的热稳定性和机械稳定性,可以提高与基材的相关密度,并为AI芯片包装带来新的突破。英特尔将在AI期间继续改变高级包装技术领域,并将继续o统治和促进行业发展,并在全球半导体行业中注入新的热情。
在AI开发浪潮中,一项技术从“幕后”转变为“舞台前”,即半导体的高级包装。这项技术可以在单个设备上使用各种功能,过程,大小和制造商的芯片组合,并以灵活,节能和成本经济的方式创建芯片上的系统(SOC)。因此,更多的AI芯片制造商更喜欢这项技术。自1970年代以来,英特尔一直在不断变化,加深了其包装技术,并积累了超过50年的丰富经验。在AI期间,英特尔与生态系统合作伙伴和基板供应商合作,汇总了制定标准并领导整个行业的高级包装技术的应用。 Intel OEM不仅可以为客户提供传统的包装,互连,基材和其他技术的概念(STCO)的概念的遵从性,而且还涵盖了系统体系结构级别S和设计服务以及全面的支持,例如热管理和功耗。包装和测试(Intel Foundry ASAT)技术的组合,包括FCBGA 2D,FCBGA 2D+,EMIB 2.5D,EMIB 3.5D,FOVEROS 2.5D 3D和FOVEROS DIRECT 3D。 FCBGA 2D是一种传统的有机FCBGA(翻转芯片球网格阵列),适用于具有敏感和低I/O数量的产品,可以降低相干关系并降低成本,特别适用于网络和转移设备等产品。 ・EMIB(嵌入式多芯片互连桥)2.5D技术通过基板内部的微硅桥连接芯片,适用于具有高芯片间密度的连接,并在AI和高表演计算场(HPC)中表现出色。 ・EMIB 3.5D在此基础上介绍了3D基础技术。芯片可以在主动或被动基材上垂直垂直垂直,然后通过EMIB技术连接,CH提高了灵活性,并允许您根据IP的特征垂直或水平搜索,同时避免使用大型介体。 ・Foveros 2.5D和3D技术采用了基于焊料的焊料,而不是基板连接,适用于高速I/或较小芯片组的设计。 ・Foveros Direct 3D技术通过直接铜和铜粘结提供了出色的性能。值得注意的是,这些技术并非既有独家店,而是可以在包装中同时采用的,从而为复杂芯片设计提供了极大的灵活性。在商业层面,它反映了农场智力的包装部分。 EMIB:正确的AI芯片包装。与其他晶圆级2.5D行业技术相比,EMIB 2.5D技术具有许多优势,例如硅插层和层崩溃(RDL)。首先,成本是有效的。 EMI使用的硅桥B技术的尺寸很小。与传统的大型插头相比,功夫可以在制造过程中更好地使用晶圆区域,减少空间和资源浪费,并且总成本较低。其次,收益率提高了。 EMIB技术消除了晶圆级组件,从而降低了由模具和颠簸等复杂过程引起的损失产量的风险,从而提高了整体劳动力过程的产量。第三,卓越劳动力。与晶圆技术相比,EMIB技术的制造步骤较少,复杂性较低,因此它具有较短的生产周期,可以在重要的时候节省客户。如果快速改变市场动态,这次的优势将帮助客户更快地获得产品的-DEREF数据,并加速产品的发布。第四,反对派的大小。晶圆水平技术需要在基板上方添加插槽层,而EMIB则将硅桥放在子板上Strate,它极大地改善了底物区域的使用。同时,底物的大小对应于集成电路面板的格式,并且使用EMIB的使用提供了单个软件包中更多芯片,以容纳更多的工作负载。第五,供应链和生产能力。英特尔具有成熟的供应链和足够的生产能力,可确保EMIB可以满足客户对高级包装解决方案的需求。未来,英特尔产生的超额包装为120×120mm,并计划在SUS Marketit上推出玻璃基材已有几年了。与当前使用的有机基材相比,玻璃基板具有独特的特性,例如超低降低平面,更好的热稳定性和机械稳定性,可以提高与基材的相关密度,并为AI芯片包装带来新的突破。英特尔将在AI期间继续改变高级包装技术领域,并将继续o统治和促进行业发展,并在全球半导体行业中注入新的热情。








 推荐文章
推荐文章






